台积电作为晶圆代工龙头企业,是全球最早量产7nm工艺的厂商,早在2018年4月就开始通过7nm工艺生产芯片,此后台积电7nm工艺为全球数十家客户服务,生产芯片超过10亿颗。
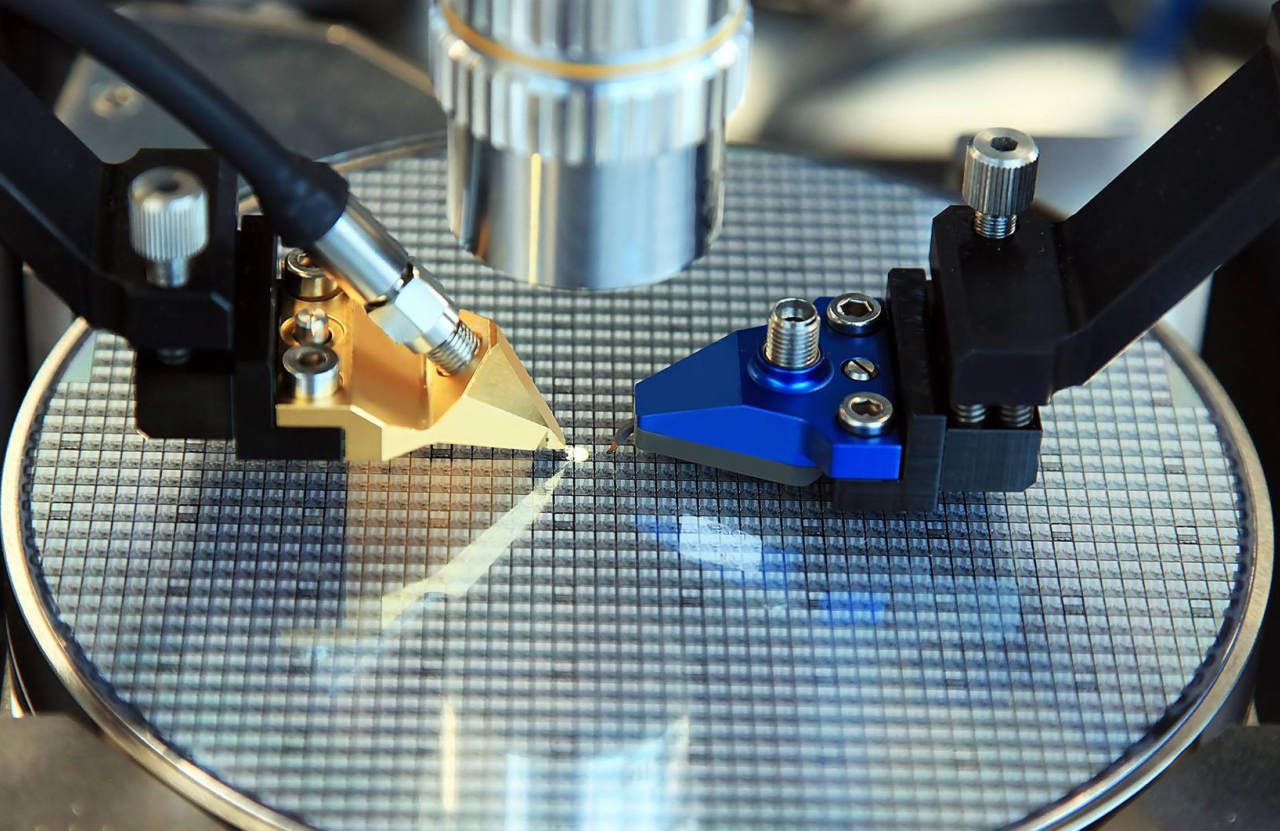
在这个过程中,台积电7nm工艺也让客户们获利颇多,比如AMD就依靠台积电的7nm工艺翻身了,还有联发科这两年推出的处理器稳定性也强了许多,甚至Intel都在找台积电代工。
尽管现在台积电5nm工艺已经实现大规模生产,但7nm工艺依然占据着不可忽视的地位,现在台积电更是一举突破7nm工艺的极限,做出了一款集成度超过600亿颗晶体管的芯片。
日前,总部位于英国的AI芯片公司Graphcore发布了一款IPU产品Bow,据官方介绍,这颗Bow IPU与上代相比,性能提升40% ,能耗比提升了16%,电源效率也提升16%。

而台积电就是Bow IPU的代工厂,但这颗IPU性能的全面提升,并非采用了更先进的制程,而是采用了和上一代IPU相同的台积电7nm工艺。
能够有如此大的提升,则是因为这颗IPU采用了3D WoW硅晶圆堆叠技术,从而实现了性能和能耗比的全面提升。
作为全球首款采用台积电3D WoW技术的芯片,Bow IPU通过这次的变化,证明了芯片性能的提升并不一定要提升工艺,也可以升级封装技术,向先进封装转移。

得益于台积电3D WoW技术的加持,Bow IPU单个封装中的晶体管数量也达到了前所未有的新高度,拥有超过600亿个晶体管,这是非常惊人的提升。
官方介绍称,Bow IPU的变化是这颗芯片采用3D封装,晶体管的规模有所增加,算力和吞吐量均得到提升,其具有350 TeraFLOPS的人工智能计算的性能,是上代的1.4倍,吞吐量从47.5TB提高到了65TB。
从这颗Bow IPU芯片的升级可以看出,过去我们理论认为芯片性能的提升很大程度上取决于工艺制程的进步,现在看来,其实也有新方向可以选择。
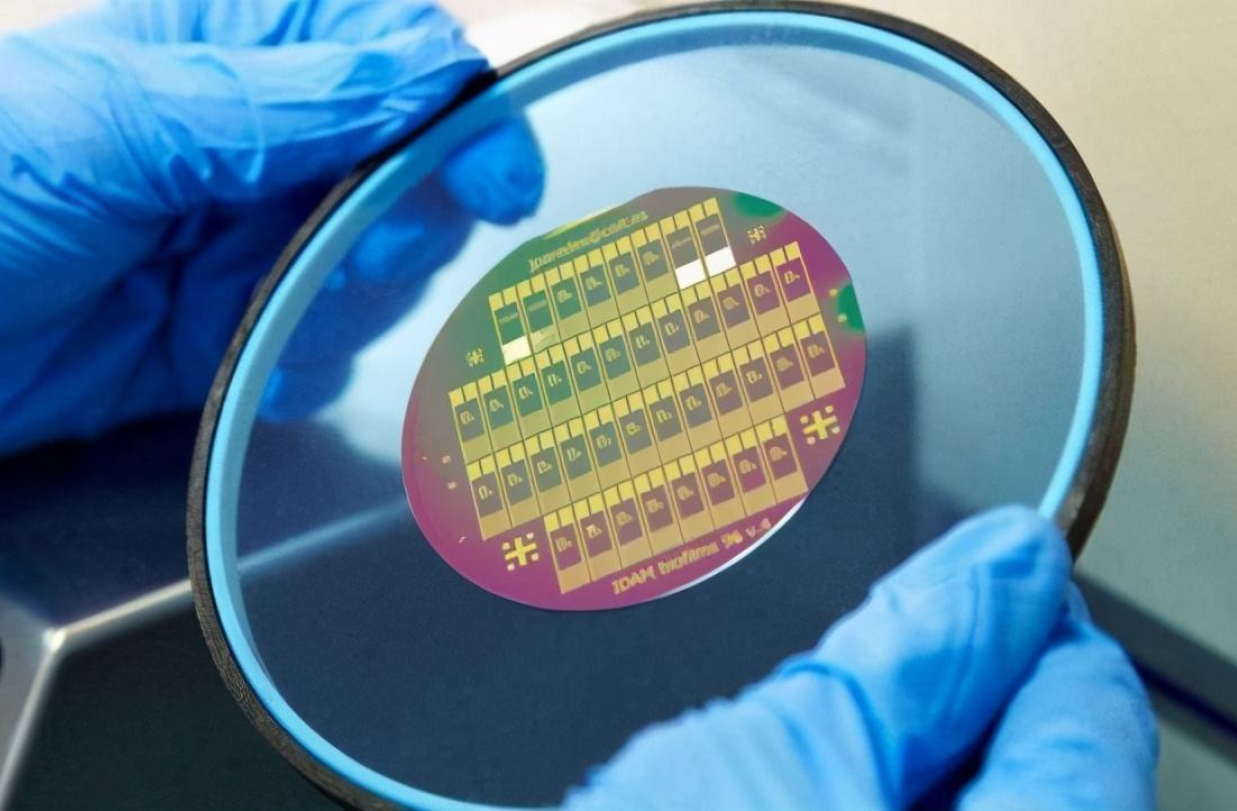
随着工艺制程的不断升级,现在的技术已经越来越逼近物理极限了, 摩尔定律逐渐失效,业界不得不通过寻找新的技术方向去延续摩尔定律,而3D封装正是被业界广泛看好的方向。
其实对于中国本土的晶圆工艺来说,3D封装也是正确的方向,由于中国大陆在先进光刻机采购问题上存在短板,导致芯片性能存在一定程度不足。
中芯国际虽然有能力攻克7nm工艺,但没有先进光刻机一切都是零,在这样的背景下,如果将3D封装技术用在28nm和14nm工艺上,或许能够有效提升性能和能耗比。

所以,笔者认为中芯国际完全可以借鉴台积电的3D封装技术方案,从而提升量产工艺的综合水平。对于这个新技术你们怎么看呢,欢迎评论、点赞、分享。






打开微信扫一扫